




1 / 5











| Product Features | Small window opening |
| Maximum Substrate Size | 610mm×630mm |
| Substrate Thickness | 0.1mm~3mm |
| Process Analysis | 35μm/50μm |
| Outer Alignment Accuracy | ±6μm |
| Energy Uniformity | ≥95% |
| Ink Color | Green / Black |
| Weight | 5500kg |

| Product Features | Production capacity preferred |
| Maximum Substrate Size | 623mm×730mm |
| Process Analysis | 40μm/60μm |
| Line Width Uniformity | ±10% |
| Exposure Time | 20 seconds/face @500mj/cm² |
| Production Efficiency | 2.5 face/min @500mj/cm² |
| Stand-alone Dimensions | 2940mm×1700mm×2195mm |
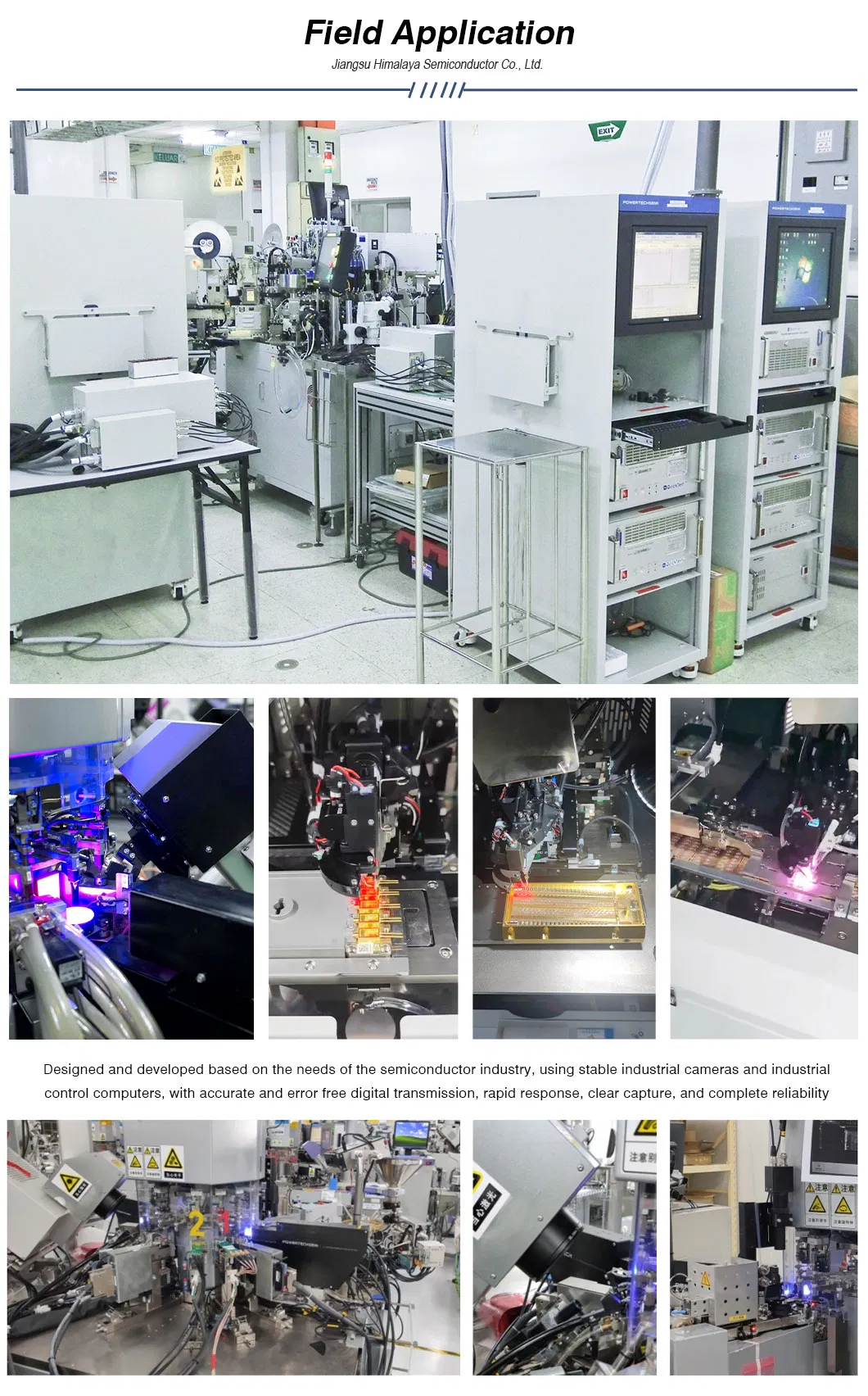
Our industrial solutions include: Die Bonder, Wire Bonding, Laser Marking (ID IC Wafer), Laser Grooving, Laser Cutting (Glass Ceramics Wafers Packaging), Laser Internal Modification Machines, and Automatic Dicing Saw Machines.


