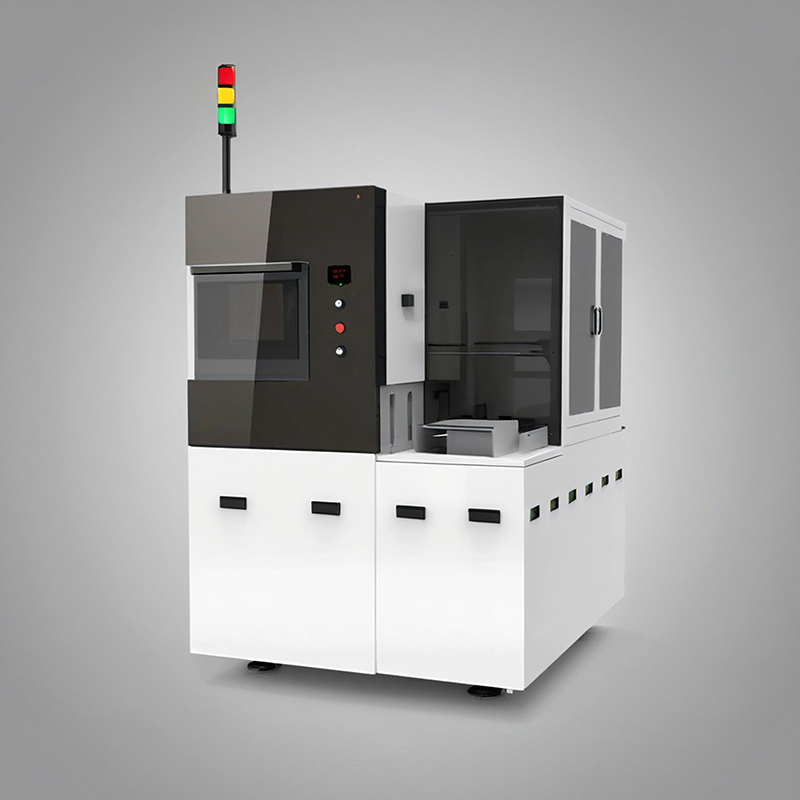
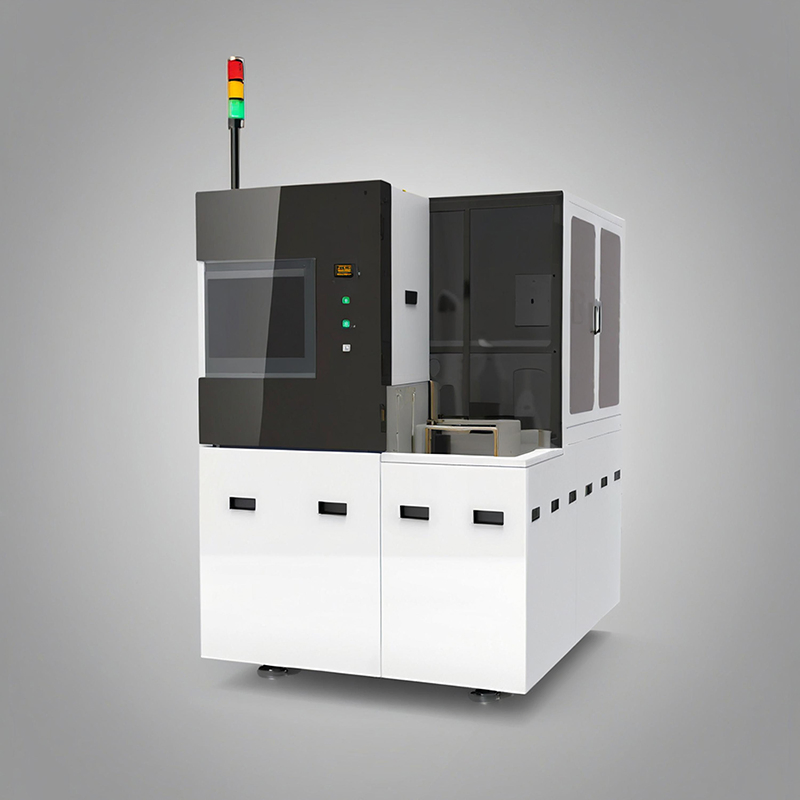
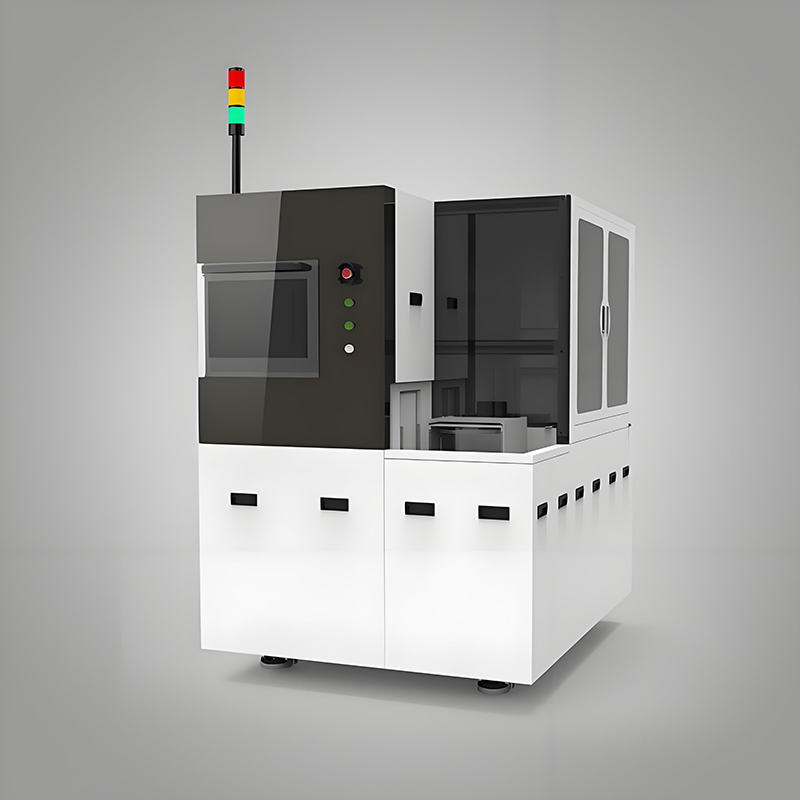
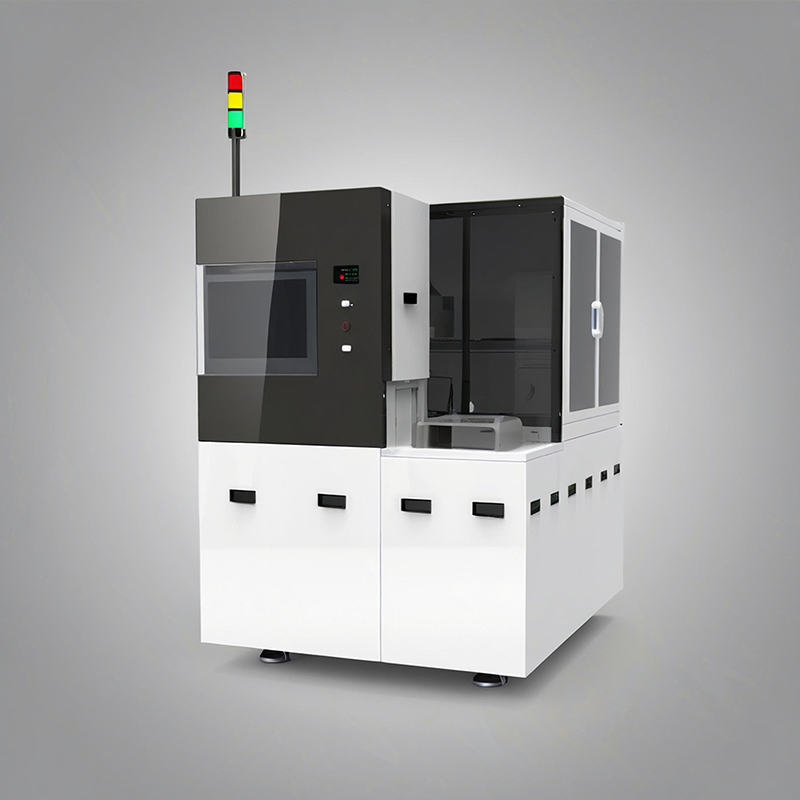
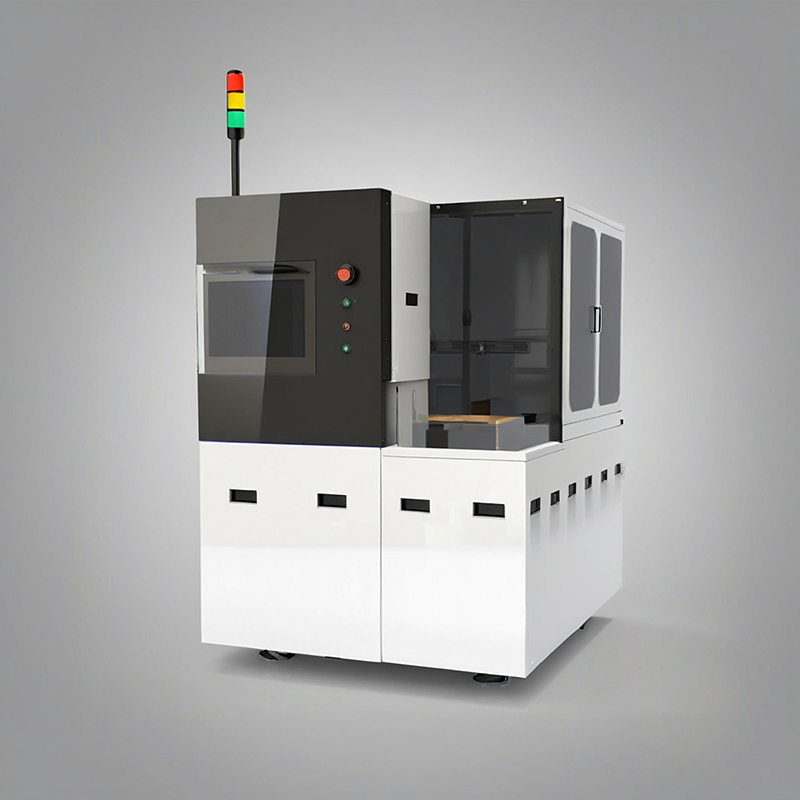
1 / 5
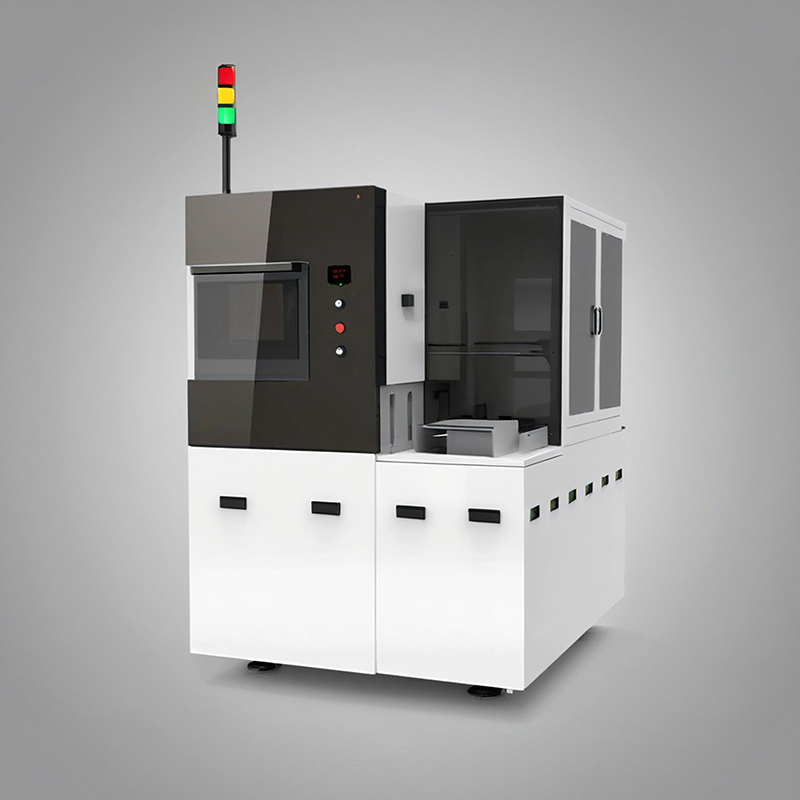
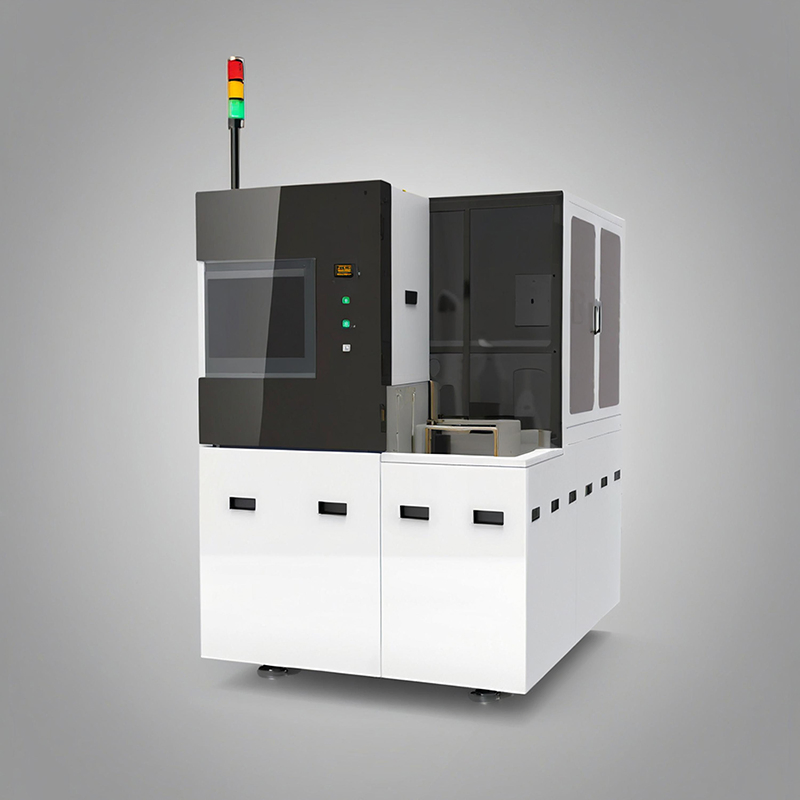
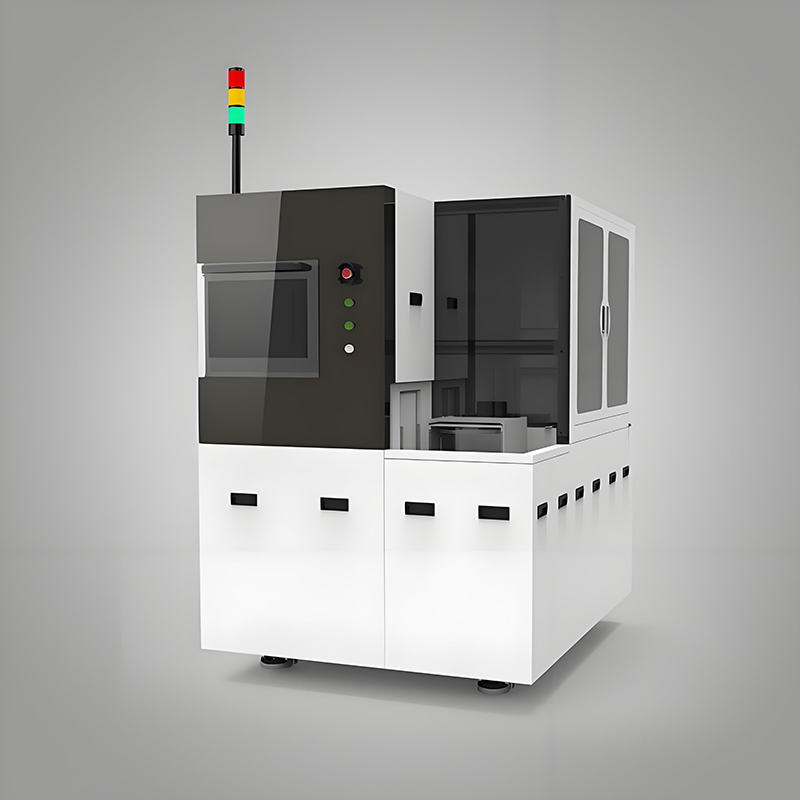
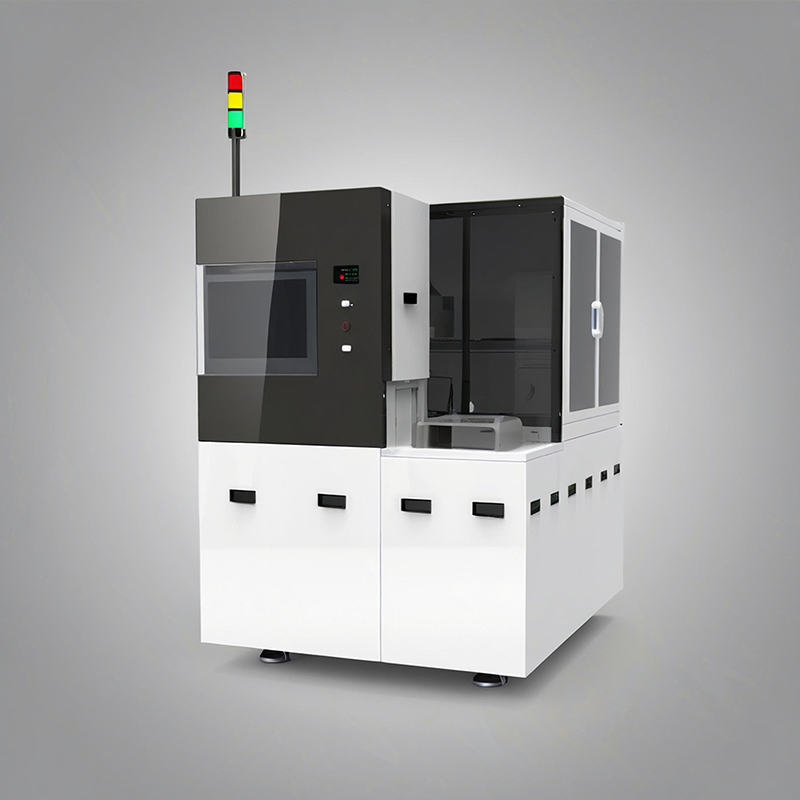
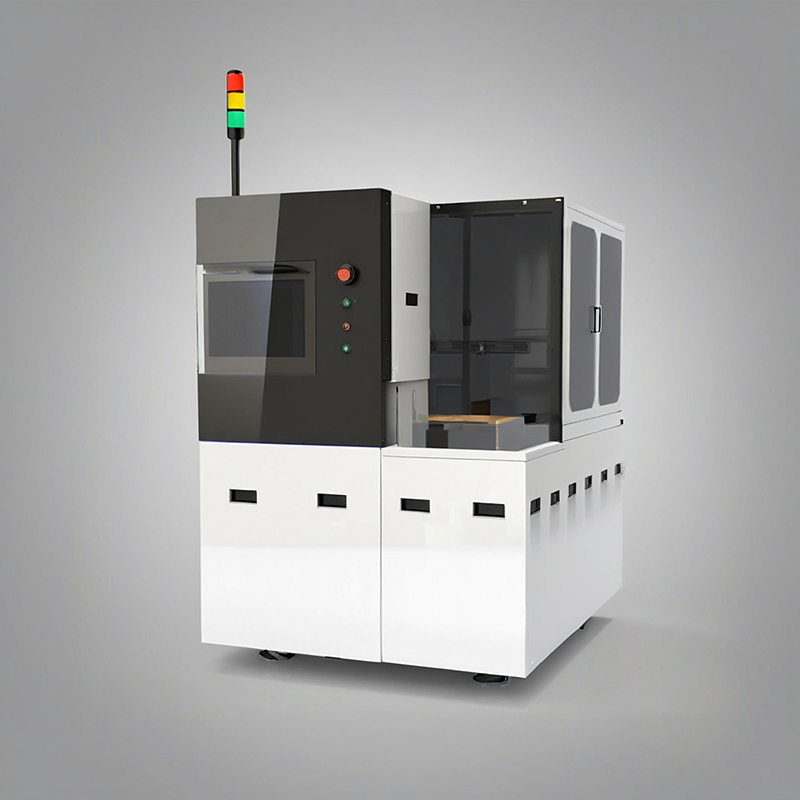
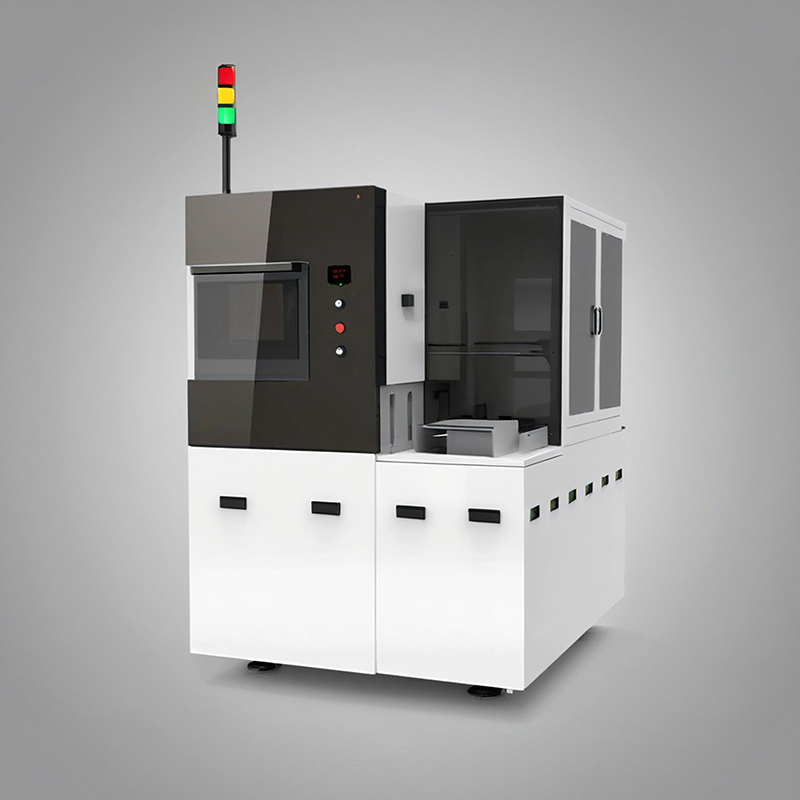
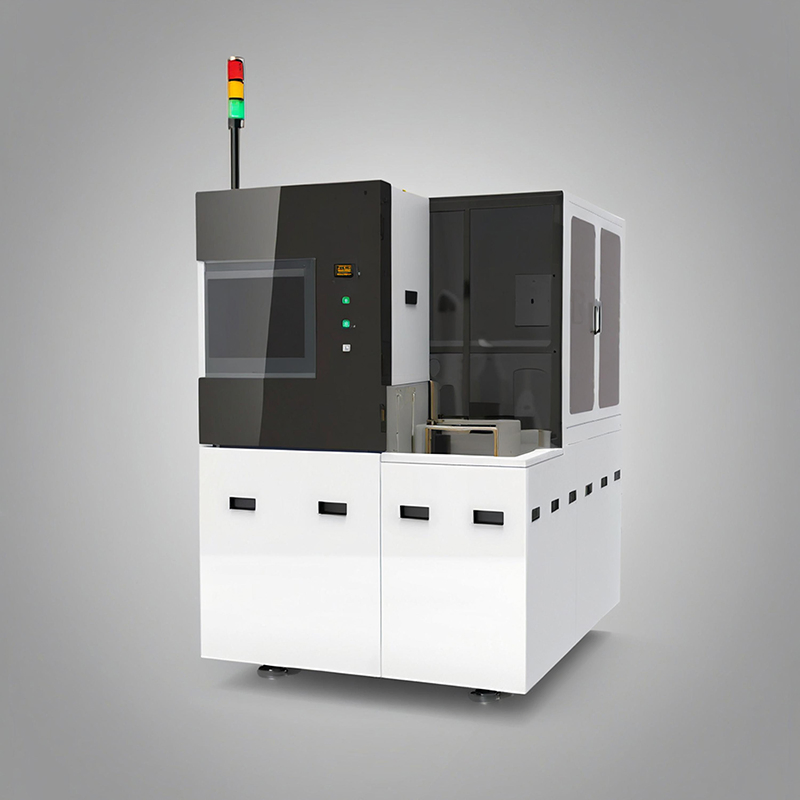
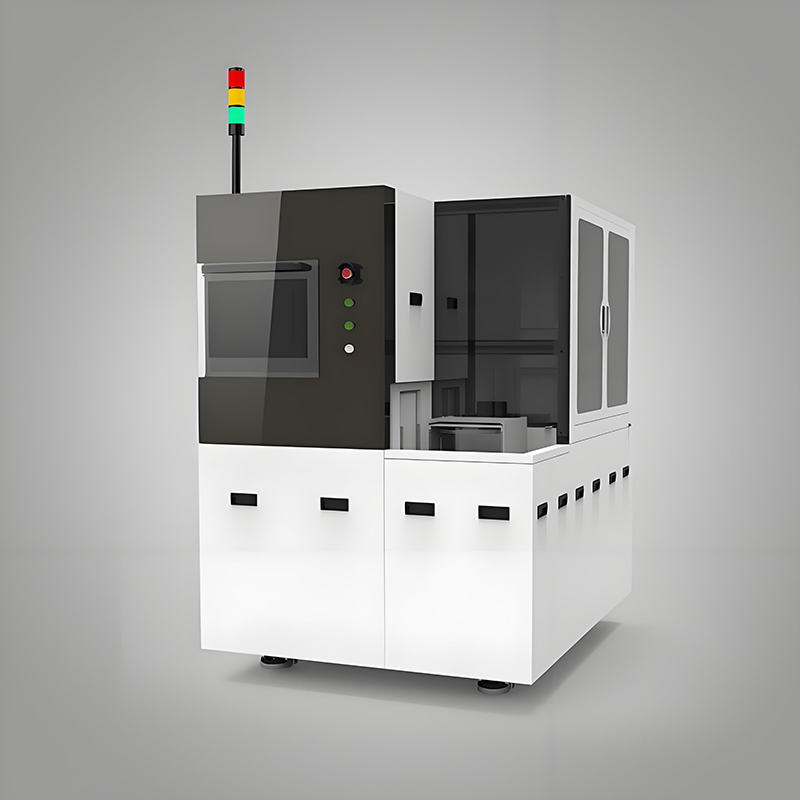
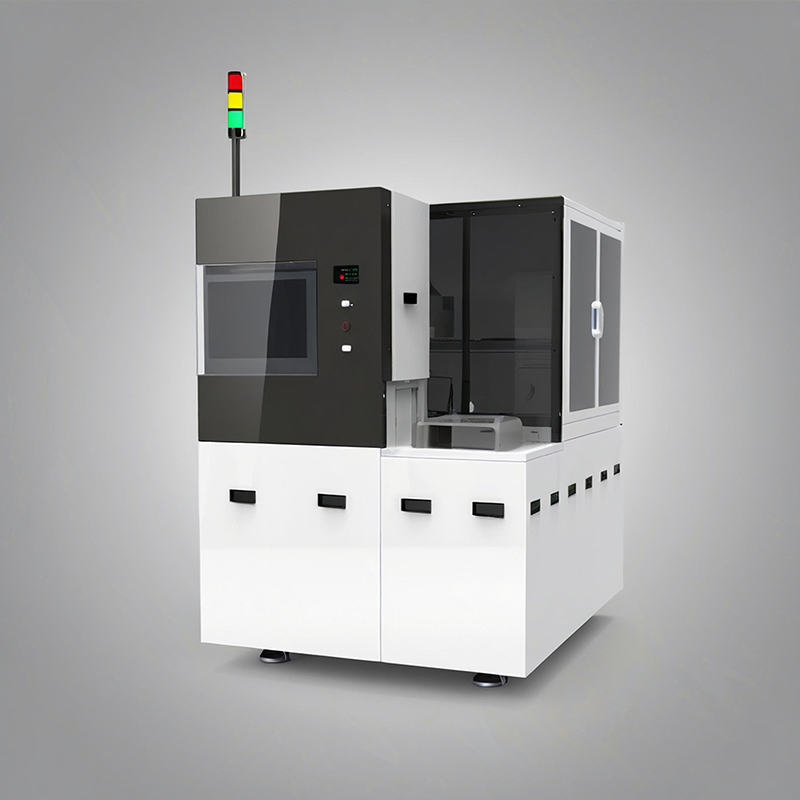
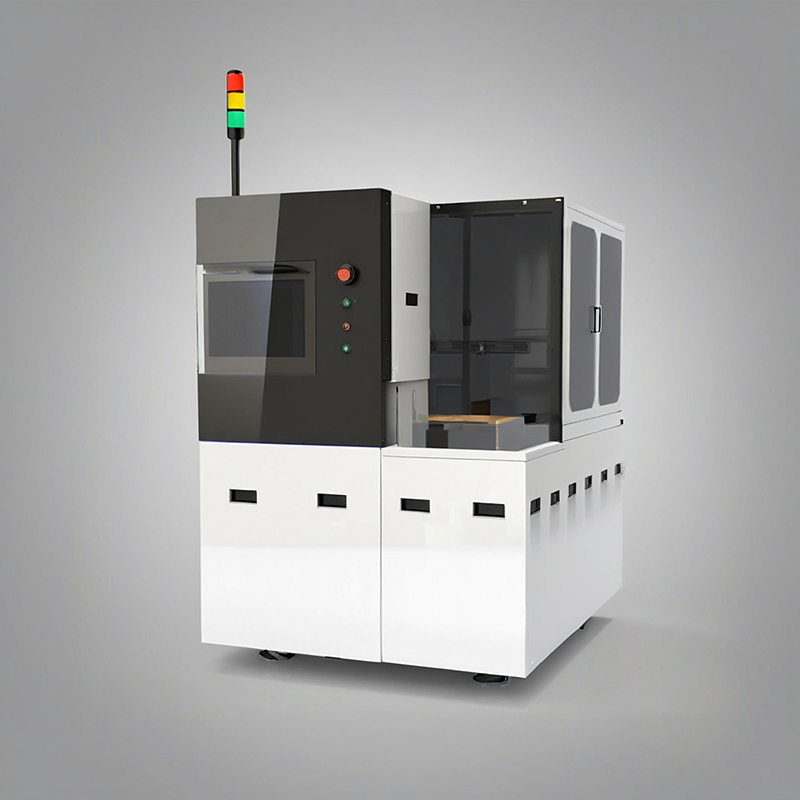
Working Principle: The machine operates by utilizing an aerostatic spindle to drive a diamond grinding wheel cutting tool at high rotational speeds. This enables precise cutting or grooving of wafers and devices along predetermined dicing streets.


| Axis / Component | Parameter | Range / Value |
|---|---|---|
| X Axis | Feed Speed Range | 310mm / 0.1-1000mm/s |
| Y Axis | Single Step Increment | 0.0001mm |
| Y Axis | Reach Accuracy | 0.003mm/310mm |
| Z Axis | Repetition Accuracy | 0.001mm |
| T Axis | Max Rotation Angle | 380° |
| Spindle | Speed Range | 6000-60000rpm |
| Spindle | Output Power | 1.8KW (2.4KW) |
| Power | Voltage Source | AC380V±10% |
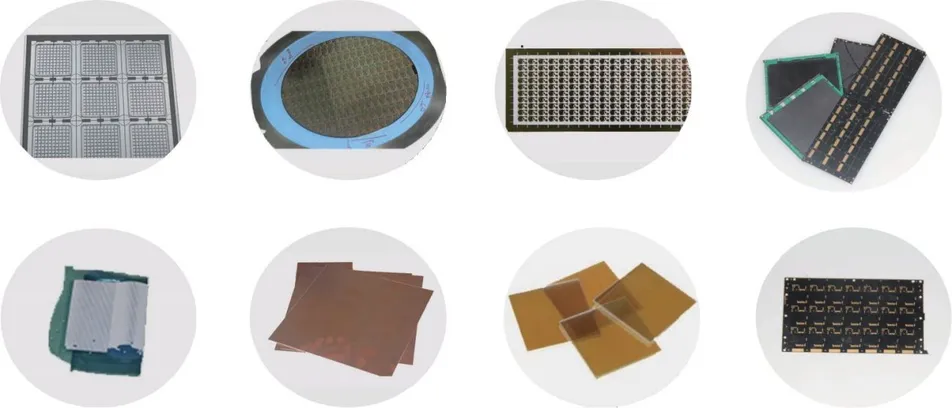






Specializing in high-performance, cost-effective semiconductor manufacturing solutions, our equipment serves a global client base across 30+ countries. We focus on delivering value through cost efficiency, secure transaction integration, and reliable technical support.